La-FMD ALD priekštecis nākotnes vadošajiem loģikas un atmiņas produktiem
Kopš 32 nm mezgla retzemju elementi ir nonākuši liela apjoma modernu loģisko ierīču ražošanā (IBM, Samsung un Globalfoundries — Chipworks 2010). Īpaši attiecībā uz Lanthanum (La) - lantanīda sērijas eponīms periodiskajā tabulā ir ieviests kā piedevas augstas k metāla vārtu kaudzes. Lantāna oksīds (La2O3, dielektriskā konstante ~ 27), piemēram, ir pētīta divas desmitgades kā augstas k vārtu dielektriķis parastā silīcija dioksīda (SiO) aizstāšanai.2) vārtu dielektriķi nākamās paaudzes tranzistoros loģikā, kā arī dinamiskās brīvpiekļuves atmiņās (DRAM).

Atslēgvārdu segmentācija patentu pieteikumu pēdējo 20 gadu laikā Lantāna un"Atomic Layer Deposition" [Patbase meklēšana, 2018. gada 15. novembris]
Atomu slāņa nogulsnēšanās ir visdaudzsološākā metode īpaši plānu La bāzes vārtu dielektriķu plēvju audzēšanai, un tāpēc pēdējos 20 gados ir veikta plaša izpēte un patentu pieteikumu iesniegšana. Pētniecības un attīstības centieni ir vērsti uz jomām, kas saistītas ar dielektriskiem un augstas k dielektriskiem lietojumiem pusvadītāju nozarē (skatīt atslēgvārdu segmentāciju iepriekš). Atomu slānis pa slāņiem plēves augšana, ko veicina pašierobežojošās virsmas reakcijas ALD, nodrošina atomiski precīzu plēves biezuma kontroli, labu viendabīgumu liela laukuma substrātā un izcilu konformitāti augstas proporcijas struktūrām, piemēram, mūsdienu FinFET un atmiņas kondensatoriem. tipa pīlāru konstrukcijas. Tomēr, lai tas darbotos nevainojami, ir nepieciešami ALD prekursori, kuriem ir noteiktas īpašības (LINK):
1. Pietiekami gaistoši (vismaz ~ 0.1 Torr līdzsvara tvaika spiediens temperatūrā, kurā tie termiski nesadalās).
2. Ātri iztvaikojošs un ar reproducējamu ātrumu (nosacījumi, kas parasti tiek ievēroti šķidriem prekursoriem, bet ne cietām vielām).
3. Pašreaģē vai nesadalās uz virsmas vai gāzes fāzē (pašizbeidzas virsmas reakcijām).
4. Ļoti reaģē ar otru reaģentu, kas iepriekš pievienots virsmai, kā rezultātā tiek panākta salīdzinoši ātra kinētika un tādējādi zemākas ALD temperatūras un cikla laiks.
5. Gaistoši blakusprodukti, kurus var viegli iztīrīt, lai sagatavotos nākamajam pusciklam.
6. Nekorozīvi blakusprodukti, lai novērstu nevienmērību plēves kodināšanas un instrumenta korozijas dēļ.
2007. gadā Intel Corporation iekļāva HfO2augstas k vārtu dielektriskajā skurstenī 45 nm tehnoloģiju mezglā. Tomēr tīrs HfO2cieš no zema k saskarnes slāņa problēmas ar Si, kas ierobežo zemākas ekvivalentā oksīda biezuma (EOT) vērtības. Tas arī viegli kristalizējas līdz pat ~500 grādiem. Tāpēc amorfie dielektriķi ar augstu termisko stabilitāti joprojām ir pieprasīti, lai tiem nebūtu raksturīgu defektu (piemēram, graudu robežām), ja tie joprojām piedāvā HfO priekšrocības2, piemēram, augsta dielektriskā konstante, plaša joslas atstarpe un zema noplūdes strāva. Trīskārši oksīdi uz lantāna bāzes, piemēram, lantāna skandāts (LaScO3) un lantāna lutecija oksīds (LaLuO3), kas nogulsnēts ALD procesā, iesaistot metāla amidināta prekursorus, kā ziņots, uzrāda vēlamas strukturālās un elektriskās īpašības. Patiesībā LaLuO3ir potenciāli labākais amorfās fāzes vārtu dielektriķis ar dielektrisko konstanti k ~ 32. Tas neveido zemas k saskarnes slāņus ar Si, kas nodrošina efektīvas oksīda biezuma (EOT) vērtības < 1 nm ar ievērojami zemu noplūdes strāvu. Vēl viens faktors, kas veicina zemo noplūdes strāvu ALD, kas ir izaudzēts plānā LaLuO3vārtu dielektriķis ir liela joslas nobīde (2,1 eV) attiecībā pret Si; simetriskas vadītspējas un valences joslu nobīdes rada vienādas noplūdes strāvas elektronu vadītos NMOSFET un caurumu vadītos PMOSFET. Tas paliek amorfs un neveido sakausējumus ar Si vai Ge pēc attiecīgās avota/noteces aktivizēšanas atkvēlināšanas.

Kā ļoti nesens piemērs faktiskai augstas proporcijas izmantošanai 300 mm plāksnēs, kam nepieciešami visi iepriekš aprakstītie ALD prekursoru raksturlielumi (1 līdz 6), mēs varam redzēt rakstu, ko Imec prezentēja šajā slavenajā IEDM konferencē par LaSiOx slāņa izmantošanu kā dipolu. ievietots HKMG kaudzē. Imec izdevās salikt visu FinFET priekšgala moduli virs "standarta" lielapjoma silīcija FinFET moduļa, demonstrējot arī labu sliekšņa sprieguma regulēšanu, uzticamību un veiktspēju zemā temperatūrā. Iespējams, ka tas ir nogulsnēts ar ALD procesu, jo tai būs atbilstoši jāpārklāj spuras un jānodrošina precīza biezuma kontrole un viendabīgums: IEDM2018 papīrs Nr. 7.1, "Pirmā 3D stacked FinFET demonstrācija ar 45 nm Fin Pitch un 110 nm Gate Pitch tehnoloģiju uz 300 mm vafelēm," A. Vandooren et al, Imec.
Tāpat kā šajā un daudzās citās lietās, stingrās kvalifikācijas ALD prekursoriem ierindo tos augstas kvalitātes speciālo ķīmisko vielu kategorijā – pēc veiktspējas vai funkcijas specifiskiem materiāliem vai molekulām pēc izvēles. Uzklātās plēves īpašības spēcīgi ietekmē vienas molekulas vai formulēta molekulu maisījuma fizikālās un ķīmiskās īpašības, kā arī tās ķīmiskais sastāvs. Tāpēc tas rada lielu spiedienu uz augstas tīrības speciālo ķīmisko vielu ražotāju un piegādātāju kvalitātes, tīrības, dokumentācijas procedūru, klientu apkalpošanas utt.
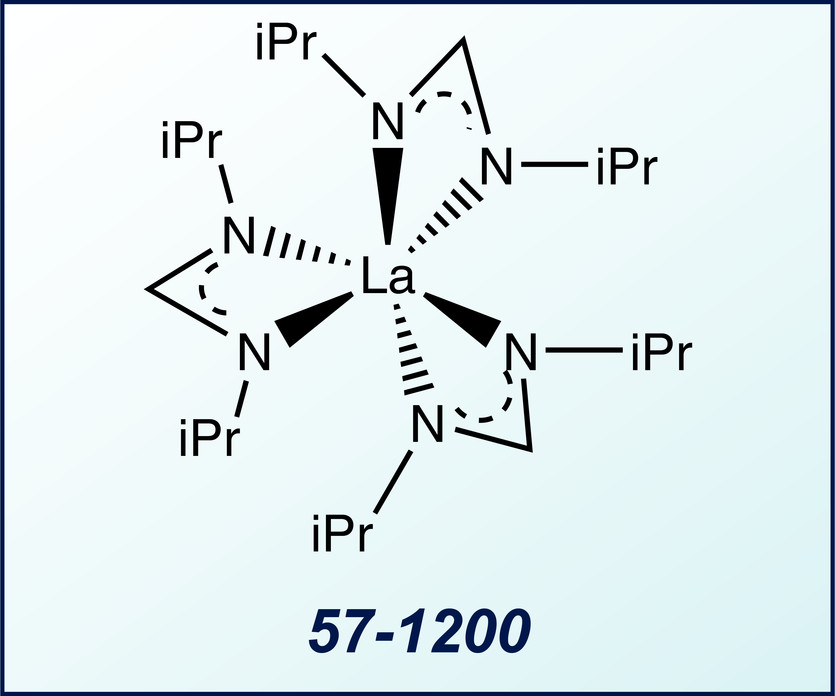
Tris(N,N'-di-i-propilformamidinato)lantāns(III), (99.999+%-La) La-FMD ir viens no La ALD metāla amidinātu prekursoriem. Materiāls ir balts vai gandrīz balts pulveris. La-FMD ķīmiskā formula un molekulmasa ir C21H45Lan6un attiecīgi 520,53. Rohm and Haas Electronic Materials LLC (pēc tam Dow Chemical) ziņo par La-FMD kā līdz šim visnepastāvīgāko La prekursoru. Tvaika spiediens noteiktā temperatūrā, ko rada La-FMD, ir augstāks nekā La(Cp)3un La(thd)3. Turklāt Rojs G. Gordons no Hārvardas universitātes ziņo, ka amidinātu prekursori ir termiski stabilāki nekā to amīda kolēģi helātu veidojošā amidīna liganda un MC saites trūkuma dēļ. La amidināti ir ļoti reaģējoši ar Si-H saitēm, kas rada daudz mazāku virsmas piesātinājuma laiku un, savukārt, ātru ALD pusreakcijas pašpārtraukšanu; tādējādi saīsinot ALD cikla laiku. Lielisku virsmas pārklājumu nodrošina arī La amidināta prekursori uz ūdeņraža gala Si.
Izcelsme no: https://www.strem.com/catalog/product_blog/160/1/strem_piedāvājumi_jauni_la-fmd{{ 7}}ald_prekursors__nākotnes_vadošajai_malai_loģikai_un{{15} }atmiņas{16}produktus
